2021-3-23일 요약
참고:
1. 한화증권 "202103-격변하는_프로세스시장" 보고서
2. 한국과학기술기획평가원: 반도체 후공정(패키징) 보고서 반도체 후공정 (패키징) - 한국과학기술기획평가원 www.kistep.re.kr
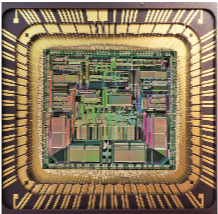
주요 반도체 기업 유형

파운드리
파운드리 시장은 고가/중저가 시장으로 명확히 나뉨. 고가 시장은 TSMC와 Samsung 단 2곳. 그래서 팹리스 업체가 파운드리를 선택하던 관행에서 현재는 파운드리 업체의 공정 로드맵에 맞춰 제품을 개발하는 상태. 파운드리가 팹리스에 최선단 공정 기술로 이끈다.
2021.03.22 - [Industries] - 삼성전자 Custom SoC 사업 확대
삼성전자 Custom SoC 사업 확대
Covid-19 팬더믹으로 여러 생각, 관점이 변화가 있어 보인다. 글로벌 공급망과 위탁을 이용해 설계 -> 위탁 -> 생산 에서 자체 설계 -> 생산으로 단축하려는 시도이며 역내 공급망을 갖추고자 하는
oldnews.tistory.com
2010년 파운드리 기업의 합산 시가총액은 1408억 달러인데 주요 파운드리는 648억 달러. 2020년 이후 전체 시가총액은 6배로 8816억 달러, 주요 파운드리 시가총액은 10배로 6453억 달러로 증가.
후공정: 패키징
SiP 을 몇 개의 층으로 구현하는 Advanced Packing(이하 AP) 이 주목
예) 애플워치에 30여개의 부품이 SiP로 집적화, 일반 패키징 대비 37% 면적 감소

후공정에서 SiP AP 가 시장 비중이 2016년 230억달러 41% 에서 2025년 422억달러 49% 높아질 예상하고 후공정 기업들은 AP를 잘 다루는 것이 관건이고 일부 파운드리는 부가가치 창출을 위해 내부에서 후공정을 영위할 수 있다.
후공정 업체 동향
후공정 Big3 기업 성장 가속화, 최첨담 후공정 기술은 거대한 자본력 필요!!! 파운드리도 TSMC와 Samsung 중심. 시장 점유율은 2012년 52%에서 2020년 66%로 크게 확대.
2012년 후공정 업체 순위는 1위 대만 ASE, 2위 미국 Amkor Technology, 3위 대만 SPIL, 4위 싱가포르 STATS ChipPAC
- ASE와 SPIL이 퀄컴과 미디어텍의 통신 칩 물량 확보
2015년 중국 JCET가 STATS ChipPAC을 인수
2016년 ASE는 SPIL을 인수->세계 최대 후공정 기업
2017년 JCET 수익성 악화. 시장 점유율 정체/하락, 중국 스마트폰용 통신칩 수요가 감소,
2019년 미국 정부의 중국 제재, 중국 반도체 산업이 침체
전략
반도체 섹터에서 비메모리 부분 시장 커진다.
1. 애플 ARM 코어 기반 CPU적용 확대
2. 이로 인한 PC업계 변화
3. 인텔 팹라이트로 파운드리 산업 확장
4. 5G, 자동차 전장 시장 확대
Samsung과 TSMC는 점차 좁혀질 것 으로 예상
1. 삼성전가가 OSAT 업체들과 파트너십 통해 HBM(High Bandwidth Memory)와 파운드리 생산 칩을 2.5D/3D 패키징에 고객 맞춤형 제품화 할 수 있다.
국내
삼성전자는 후공정인 웨이퍼 레벨 팬아웃 패지키 도입을 서두르고, 디램 기술을 바탕으로 초고속 인터페이스를 활용한 패키지 기술을 토털 솔루션으로 제공 가능하다.
- 2016년 TSMC가 팬아웃 패키징으로 애플 물량 독식!
- 국내 OSAT(Outsourced Semiconductor Assembly and Test) 업체: 네패스 양산 성공
2018.10.23, www.thelec.kr/news/articleView.html?idxno=100
삼성, 천안 Fo-WLP 파일럿 라인 구축... 갤S11 AP 팬아웃 기술 적용 목표 - 전자부품 전문 미디어 디일
삼성전자에서 반도체 사업을 관장하는 디바이스솔루션(DS) 부문이 팬아웃-웨이퍼레벨패키지(Fo-WLP) 연구개발(R&D) 및 파일럿 라인을 구축하고 있는 것으로 확인됐다. 내후년 출시 예정인 갤럭시S11
www.thelec.kr
it.chosun.com/site/data/html_dir/2020/03/21/2020032100271.html
삼성전자, 반도체 후공정 주도권 탈환 나섰다...팬아웃 기술 도입 박차
삼성전자가 반도체 후공정 시장 탈환에 나섰다. 현재 대만 TSMC는 삼성을 제치고 애플 수주를 독점하고 있다. 차세대 반도체 후공정 기술로 주목..
it.chosun.com
Fan-Out 기술
Fan-Out(FO) 기술은 PCB 기판을 사용하지 않고 칩과 칩 바깥 영역의 입출력 단자를 연결함으로써 집적화와 전기적 성능향상 구현
90nm 공정에서 주로 사용되었던 Fan-In(FI) 방식의 WLP(Wafer Level Package)기술은 45nm 이하부터 개별 IC에 RDL 과 Bump 들을 배열할 공간의 부족 문제에 따라 IC 면적 외부까지의 공간을 활용할 수 있는 Fan-Out(FO)기술 개발・도입


국내 주요 기업
반도체 장비 기업: 원익IPS
후공정 기업: 엘비세미콘, 네패스, 하나마이크론, 테스나
반도체 테스트 소켓: 리노 공업
'Industries' 카테고리의 다른 글
| 반도체 장비의 유아독존 ASML EUV 장비 (0) | 2021.03.25 |
|---|---|
| 20210323~0327 반도체 관련(업데이트) (0) | 2021.03.24 |
| 삼성전자 Custom SoC 사업 확대 (0) | 2021.03.22 |
| 자율주행/자율운전 차량의 부수효과? (0) | 2021.03.20 |
| 20210315-20 반도체 관련 (0) | 2021.03.19 |




댓글